
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Dislocazione nei cristalli di SiC
Il substrato SiC può presentare difetti microscopici, come la dislocazione della vite filettata (TSD), la dislocazione del bordo filettato (TED), la dislocazione del piano base (BPD) e altri. Questi difetti sono causati da deviazioni nella disposizione degli atomi a livello atomico.
SiC crystals typically grow in a way that extends parallel to the c-axis or at a small angle with it, which means that the c-plane is also known as the base plane. There are two main types of dislocations in the crystal. When the dislocation line is perpendicular to the base plane, the crystal inherits dislocations from the seed crystal into the epitaxial grown crystal. These dislocations are known as penetrating dislocations and can be categorized into threading edge dislocations(TED) and threading screw dislocations(TSD) based on the orientation of the Bernoulli vector to the dislocation line. Dislocations, where both the dislocation lines and the Brönsted vectors are in the base plane, are called base plane dislocations(BPD). SiC crystals can also have composite dislocations, which are a combination of the above dislocations.
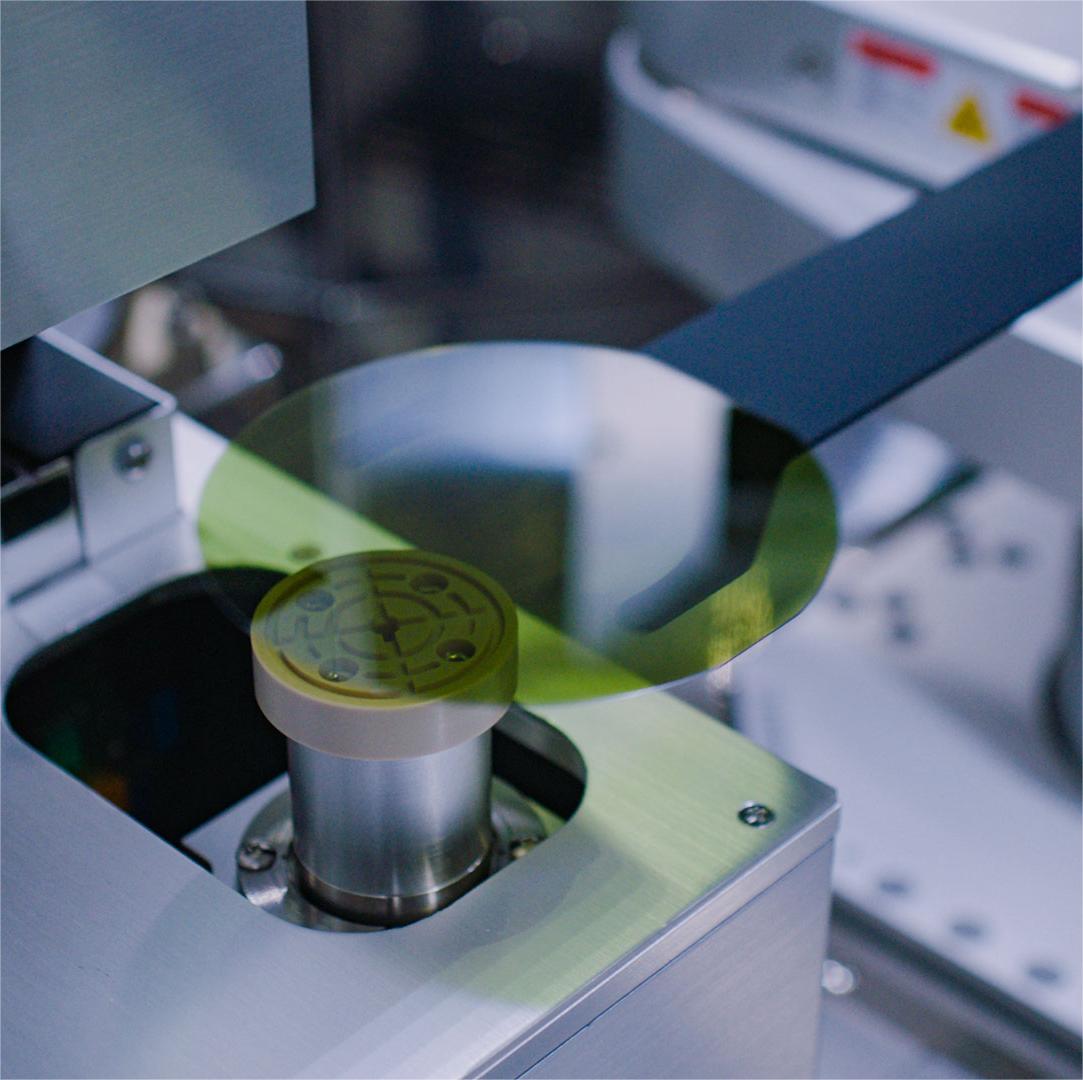
1. TED&TSD
Sia le dislocazioni filettate (TSD) che le dislocazioni dei bordi filettati (TED) corrono lungo l'asse di crescita [0001] con diversi vettori Burgers di <0001> e 1/3 <11-20>, rispettivamente.
Sia i TSD che i TED possono estendersi dal substrato alla superficie del wafer e produrre piccole caratteristiche superficiali simili a fossette. Tipicamente, la densità dei TED è di circa 8.000-10.000 1/cm2, ovvero quasi 10 volte quella dei TSD.
Durante il processo di crescita epitassiale del SiC, il TSD si estende dal substrato allo strato epitassiale del TSD esteso, può trasformarsi in altri difetti sul piano del substrato e propagarsi lungo l'asse di crescita.
It has been shown that during SiC epitaxial growth, TSD is transformed into stacking layer faults (SF) or carrot defects on the substrate plane, while TED in the epitaxial layer is shown to be transformed from BPD inherited from the substrate during epitaxial growth.
2. BPD
Le dislocazioni del piano basale (BPD), che si trovano nel piano [0001] dei cristalli di SiC, hanno un vettore di Burgers di 1/3 <11-20>.
I BPD compaiono raramente sulla superficie dei wafer SiC. Questi sono solitamente concentrati sul substrato ad una densità di 1500 1/cm2, mentre la loro densità nello strato epitassiale è solo di circa 10 1/cm2.
Resta inteso che la densità dei BPD diminuisce con l'aumentare dello spessore del substrato SiC. Se esaminati utilizzando la fotoluminescenza (PL), i BPD mostrano caratteristiche lineari. Durante il processo di crescita epitassiale del SiC, il BPD esteso può essere trasformato in SF o TED.
Da quanto sopra, è evidente che sono presenti difetti nel wafer del substrato SiC. Questi difetti possono essere ereditati nella crescita epitassiale dei film sottili, che possono causare danni fatali al dispositivo SiC. Ciò può portare alla perdita dei vantaggi del SiC come un elevato campo di rottura, un'elevata tensione inversa e una bassa corrente di dispersione. Inoltre, ciò può ridurre il tasso di qualificazione del prodotto e porre enormi ostacoli all’industrializzazione del SiC a causa della ridotta affidabilità.




