
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Tecnologia di incisione selettiva SiGe e Si
Il Gate-All-Around FET (GAAFET), in quanto architettura a transistor di nuova generazione pronta a sostituire il FinFET, ha raccolto un'attenzione significativa per la sua capacità di fornire un controllo elettrostatico superiore e prestazioni migliorate in dimensioni più piccole. Un passaggio fondamentale nella fabbricazione di GAAFET di tipo n riguarda l'elevata selettivitàacquafortedi stack SiGe:Si prima della deposizione di distanziatori interni, generando nanofogli di silicio e rilasciando canali.

Questo articolo approfondisce il selettivotecnologie di incisionecoinvolto in questo processo e introduce due nuovi metodi di attacco: l'attacco senza plasma con gas altamente ossidativo e l'attacco dello strato atomico (ALE), che offrono nuove soluzioni per ottenere elevata precisione e selettività nell'attacco SiGe.
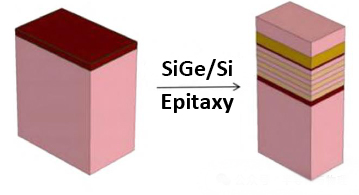
Strati di superreticolo SiGe in strutture GAA
Nella progettazione dei GAAFET, per migliorare le prestazioni del dispositivo, sono presenti strati alternati di Si e SiGecresciuto epitassialmente su un substrato di silicio, formando una struttura multistrato nota come superreticolo. Questi strati di SiGe non solo regolano la concentrazione del portatore ma migliorano anche la mobilità degli elettroni introducendo stress. Tuttavia, nelle fasi successive del processo, questi strati di SiGe devono essere rimossi con precisione mantenendo gli strati di silicio, richiedendo tecnologie di attacco altamente selettive.
Metodi per l'incisione selettiva di SiGe
Acquaforte senza plasma con gas altamente ossidativo
La selezione del gas ClF3: questo metodo di attacco utilizza gas altamente ossidanti con estrema selettività, come ClF3, ottenendo un rapporto di selettività SiGe:Si di 1000-5000. Può essere completato a temperatura ambiente senza causare danni al plasma.
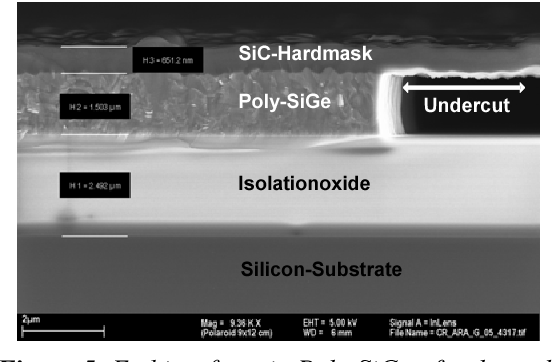
Efficienza a bassa temperatura: la temperatura ottimale è di circa 30°C, realizzando un attacco ad alta selettività in condizioni di bassa temperatura, evitando ulteriori aumenti del budget termico, che è fondamentale per mantenere le prestazioni del dispositivo.
Ambiente secco: L'interoprocesso di incisioneviene condotto in condizioni completamente asciutte, eliminando il rischio di adesione della struttura.
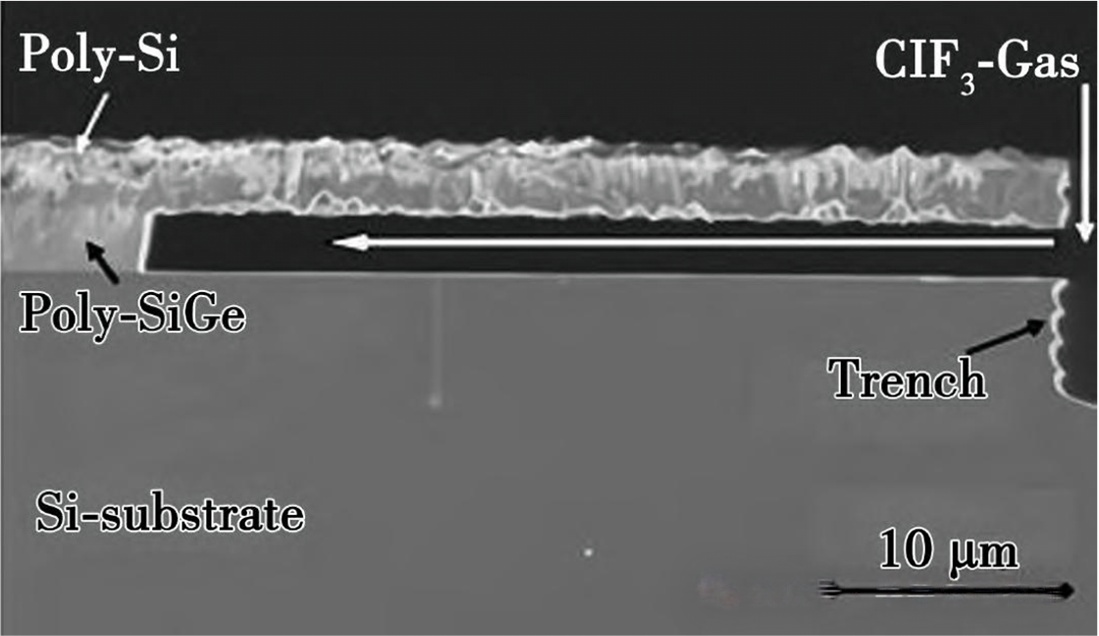
Incisione di strati atomici (ALE)
Caratteristiche autolimitanti: ALE è un ciclico in due fasitecnologia dell'incisione, dove viene prima modificata la superficie del materiale da incidere, e poi lo strato modificato viene rimosso senza intaccare le parti non modificate. Ogni passaggio è autolimitante, garantendo una precisione tale da rimuovere solo pochi strati atomici alla volta.
Incisione ciclica: i due passaggi sopra menzionati vengono ripetuti ciclicamente fino al raggiungimento della profondità di incisione desiderata. Questo processo consente ad ALE di raggiungereincisione di precisione a livello atomicoin cavità di piccole dimensioni sulle pareti interne.

Noi di Semicorex siamo specializzati inSoluzioni di grafite rivestita SiC/TaCapplicato nei processi di incisione nella produzione di semiconduttori, se hai domande o hai bisogno di ulteriori dettagli, non esitare a contattarci.
Telefono di contatto: +86-13567891907
E-mail: sales@semicorex.com




