
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe nella produzione di chip: un reportage professionale
L'evoluzione dei materiali semiconduttori
Nel campo della moderna tecnologia dei semiconduttori, la spinta incessante verso la miniaturizzazione ha spinto i limiti dei tradizionali materiali a base di silicio. Per soddisfare le richieste di prestazioni elevate e basso consumo energetico, il SiGe (silicone germanio) è emerso come materiale composito preferito nella produzione di chip semiconduttori grazie alle sue proprietà fisiche ed elettriche uniche. Questo articolo approfondisce ilprocesso epitassiadi SiGe e il suo ruolo nella crescita epitassiale, nelle applicazioni di silicio deformato e nelle strutture Gate-All-Around (GAA).
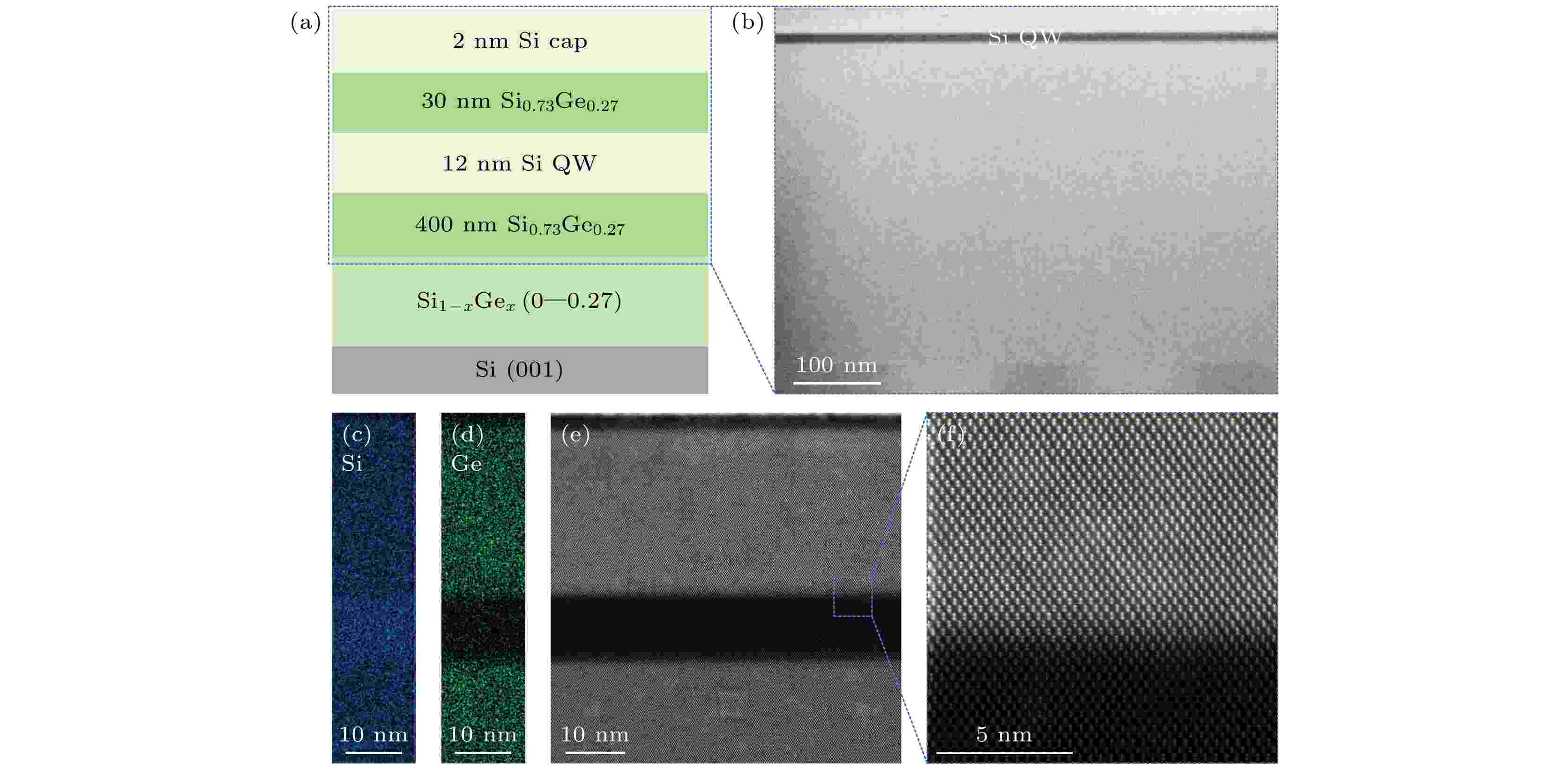
Il significato dell'epitassia SiGe
1.1 Introduzione all'epitassia nella produzione di chip:
L'epitassia, spesso abbreviata in Epi, si riferisce alla crescita di uno strato monocristallino su un substrato monocristallino con la stessa disposizione reticolare. Questo livello può essere uno dei dueomoepitassiale (come Si/Si)o eteroepitassiale (come SiGe/Si o SiC/Si). Vari metodi vengono utilizzati per la crescita epitassiale, tra cui l'epitassia a fascio molecolare (MBE), la deposizione chimica in fase vapore ad altissimo vuoto (UHV/CVD), l'epitassia atmosferica e a pressione ridotta (ATM e RP Epi). Questo articolo si concentra sui processi di epitassia del silicio (Si) e del silicio-germanio (SiGe) ampiamente utilizzati nella produzione di circuiti integrati a semiconduttore con silicio come materiale di substrato.
1.2 Vantaggi dell'epitassia SiGe:
Incorporando una certa proporzione di germanio (Ge) durante ilprocesso epitassiaforma uno strato monocristallino di SiGe che non solo riduce la larghezza di banda proibita ma aumenta anche la frequenza di taglio del transistor (fT). Ciò lo rende ampiamente applicabile nei dispositivi ad alta frequenza per comunicazioni wireless e ottiche. Inoltre, nei processi avanzati di circuiti integrati CMOS, il disadattamento reticolare (circa il 4%) tra Ge e Si introduce stress reticolare, migliorando la mobilità di elettroni o lacune e aumentando così la corrente di saturazione e la velocità di risposta del dispositivo.
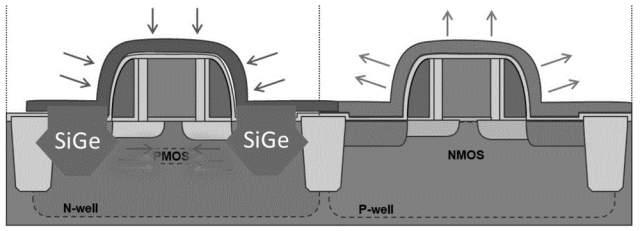
Il flusso completo del processo di epitassia SiGe
2.1 Pretrattamento:
I wafer di silicio vengono pretrattati in base ai risultati del processo desiderati, che comportano principalmente la rimozione dello strato di ossido naturale e delle impurità sulla superficie del wafer. Per i wafer di substrato fortemente drogati, è fondamentale considerare se la sigillatura posteriore è necessaria per ridurre l'auto-drogaggio durante le successivecrescita epitassia.
2.2 Gas di crescita e condizioni:
Gas di silicio: silano (SiH₄), diclorosilano (DCS, SiH₂Cl₂) e triclorosilano (TCS, SiHCl₃) sono le tre fonti di gas di silicio più comunemente utilizzate. SiH₄ è adatto per processi di epitassia completa a bassa temperatura, mentre il TCS, noto per il suo rapido tasso di crescita, è ampiamente utilizzato per la preparazione di spessiepitassia del siliciostrati.
Gas di germanio: il germanio (GeH₄) è la fonte primaria per l'aggiunta di germanio, utilizzato insieme a fonti di silicio per formare leghe SiGe.
Epitassia selettiva: la crescita selettiva si ottiene regolando i tassi relativi dideposizione epitassialee attacco in situ, utilizzando DCS di gas di silicio contenente cloro. La selettività è dovuta al fatto che l'adsorbimento degli atomi di Cl sulla superficie del silicio è inferiore a quello degli ossidi o dei nitruri, facilitando la crescita epitassiale. Il SiH₄, privo di atomi di Cl e con bassa energia di attivazione, viene generalmente applicato solo a processi di epitassia completa a bassa temperatura. Un'altra fonte di silicio comunemente usata, il TCS, ha una bassa pressione di vapore ed è liquida a temperatura ambiente, richiedendo gorgogliamento di H₂ per introdurla nella camera di reazione. Tuttavia, è relativamente economico e spesso utilizzato per il suo rapido tasso di crescita (fino a 5 μm/min) per far crescere strati di epitassia di silicio più spessi, ampiamente applicati nella produzione di wafer di epitassia di silicio.
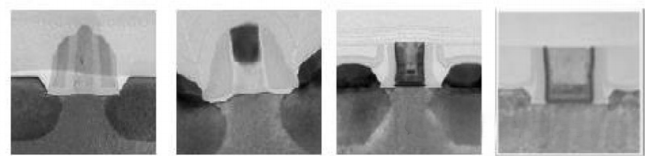
Silicio filtrato in strati epitassiali
Durantecrescita epitassiale, il Si monocristallino epitassiale è depositato su uno strato di SiGe rilassato. A causa del disadattamento reticolare tra Si e SiGe, lo strato monocristallino di Si è soggetto a stress di trazione dallo strato di SiGe sottostante, migliorando significativamente la mobilità degli elettroni nei transistor NMOS. Questa tecnologia non solo aumenta la corrente di saturazione (Idsat) ma migliora anche la velocità di risposta del dispositivo. Per i dispositivi PMOS, gli strati di SiGe vengono cresciuti epitassialmente nelle regioni di source e drain dopo l'attacco per introdurre stress di compressione sul canale, migliorando la mobilità dei fori e aumentando la corrente di saturazione.
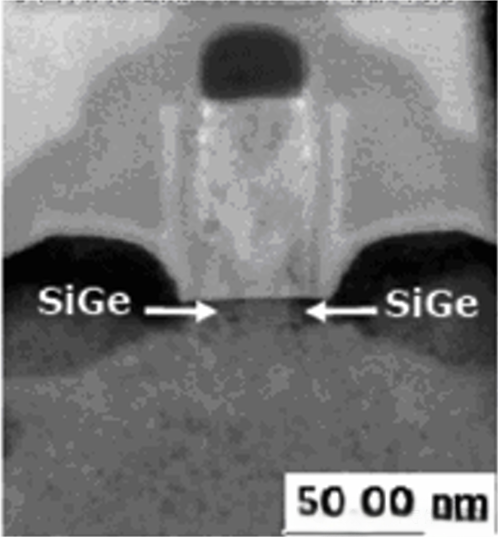
SiGe come strato sacrificale nelle strutture GAA
Nella produzione di transistor nanofili Gate-All-Around (GAA), gli strati SiGe agiscono come strati sacrificali. Le tecniche di attacco anisotropo ad alta selettività, come l'attacco di strati quasi atomici (quasi-ALE), consentono la rimozione precisa degli strati di SiGe per formare strutture di nanofili o nanofogli.
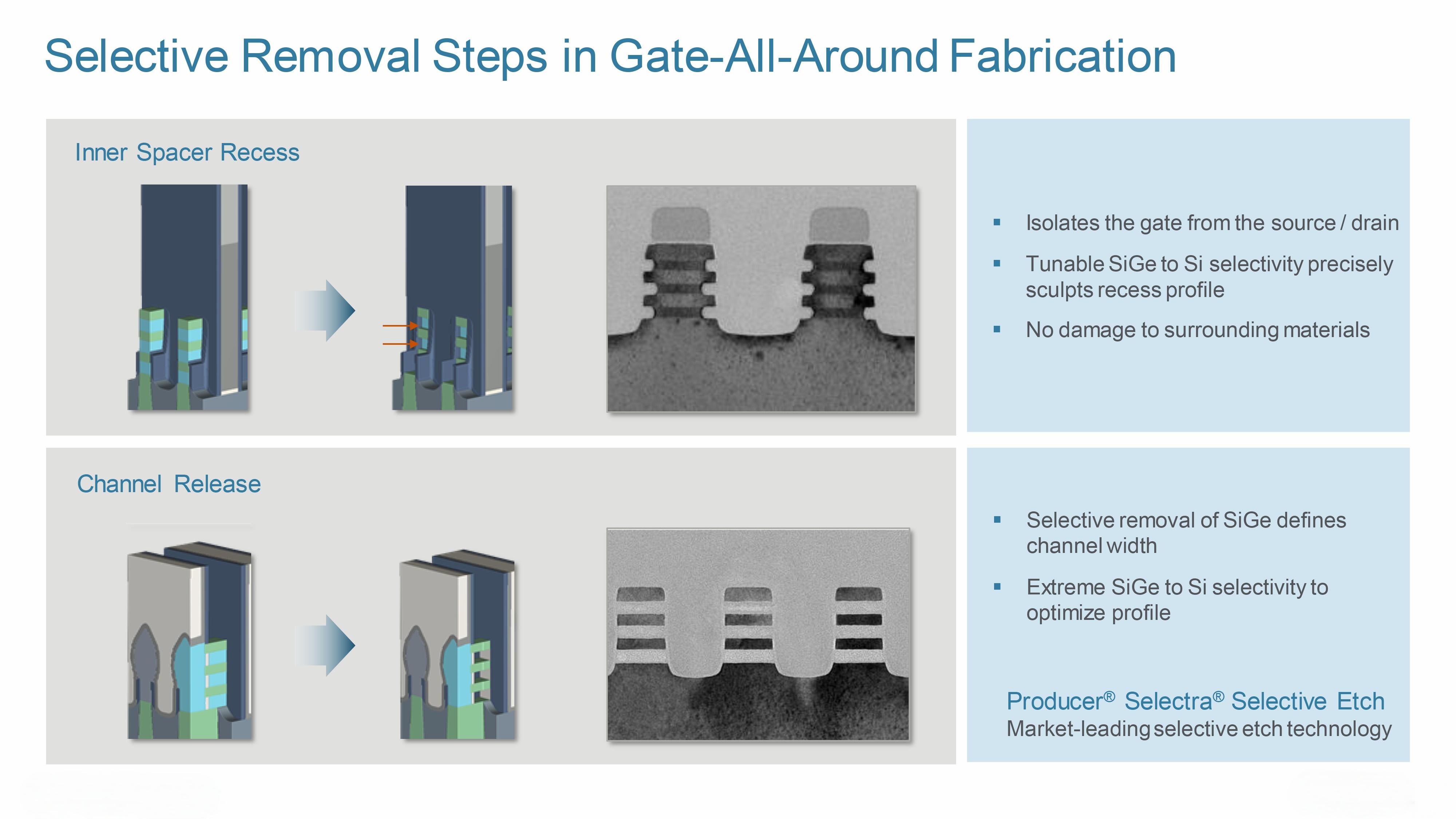
Noi di Semicorex siamo specializzati inSoluzioni di grafite rivestita SiC/TaCapplicato nella crescita epitassiale Si nella produzione di semiconduttori, se hai domande o hai bisogno di ulteriori dettagli, non esitare a contattarci.
Telefono di contatto: +86-13567891907
E-mail: sales@semicorex.com




