
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Metodi di distacco tradizionali
Con il progresso della lavorazione dei semiconduttori e la crescente domanda di componenti elettronici, l'applicazione di wafer ultrasottili (spessore inferiore a 100 micrometri) è diventata sempre più critica. Tuttavia, con la continua riduzione dello spessore dei wafer, i wafer sono altamente vulnerabili alla rottura durante i processi successivi, come la macinazione, l'incisione e la metallizzazione.
Le tecnologie di incollaggio e distacco temporaneo vengono generalmente applicate per garantire prestazioni stabili e resa produttiva dei dispositivi a semiconduttore. Il wafer ultrasottile viene temporaneamente fissato su un substrato portante rigido e, dopo la lavorazione sul retro, i due vengono separati. Questo processo di separazione è noto come debonding, che comprende principalmente il debonding termico, il debonding laser, il debonding chimico e il debonding meccanico.
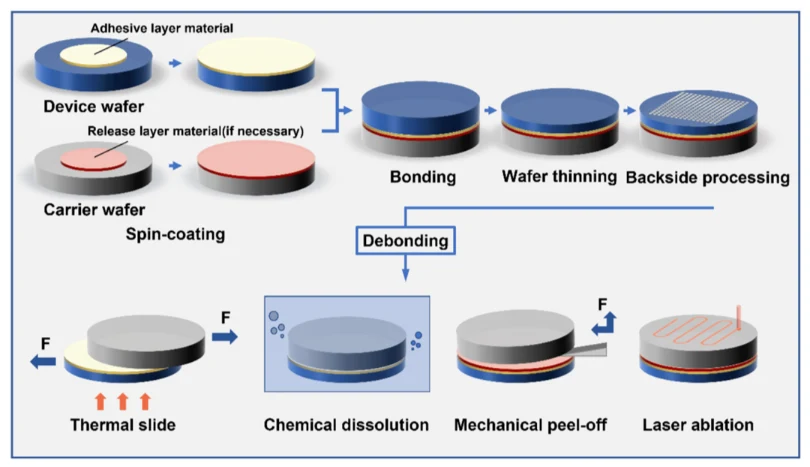
Debonding termico
Il debonding termico è un metodo che separa i wafer ultrasottili dai substrati di supporto mediante riscaldamento per ammorbidire e decomporre l'adesivo di collegamento, perdendo così la sua adesività. Si divide principalmente in debonding con scorrimento termico e debonding con decomposizione termica.
Il distacco termico su diapositiva di solito comporta il riscaldamento dei wafer incollati alla loro temperatura di rammollimento, che varia approssimativamente da 190°C a 220°C. A questa temperatura, l'adesivo di collegamento perde la sua adesività e i wafer ultrasottili possono essere spinti o staccati lentamente dai substrati di supporto grazie alla forza di taglio applicata da dispositivi comemandrini a vuotoper ottenere una separazione uniforme. Durante il distacco tramite decomposizione termica, i wafer incollati vengono riscaldati a una temperatura più elevata, provocando la decomposizione chimica (scissione della catena molecolare) dell'adesivo e perdendone completamente l'adesione. Di conseguenza, i wafer incollati possono essere staccati naturalmente senza alcuna forza meccanica.
Debonding laser
Il debonding laser è un metodo di debonding che utilizza l'irradiazione laser sullo strato adesivo dei wafer incollati. Lo strato adesivo assorbe l'energia del laser e genera calore, subendo così una reazione fotolitica. Questo approccio consente la separazione di wafer ultrasottili dai substrati portanti a temperatura ambiente o a temperature relativamente basse.
Tuttavia, un prerequisito cruciale per il debonding laser è che il substrato portante sia trasparente alla lunghezza d’onda del laser utilizzata. In questo modo l'energia laser può penetrare con successo nel substrato portante ed essere assorbita efficacemente dal materiale dello strato adesivo. Per questo motivo, la scelta della lunghezza d’onda del laser è fondamentale. Le lunghezze d'onda tipiche includono 248 nm e 365 nm, che dovrebbero essere adattate alle caratteristiche di assorbimento ottico del materiale legante.
Debonding chimico
Il debonding chimico consente di ottenere la separazione dei wafer incollati sciogliendo lo strato adesivo di collegamento con un solvente chimico dedicato. Questo processo richiede che le molecole di solvente penetrino nello strato adesivo provocando rigonfiamento, scissione della catena ed eventuale dissoluzione, che consente ai wafer ultrasottili e ai substrati portanti di separarsi naturalmente. Pertanto, non sono necessarie apparecchiature di riscaldamento aggiuntive o forza meccanica fornita dai mandrini a vuoto, il distacco chimico genera uno stress minimo sui wafer.
In questo metodo, i wafer di supporto sono spesso preforati per consentire al solvente di entrare completamente in contatto e dissolvere lo strato adesivo. Lo spessore dell'adesivo influisce sull'efficienza e sull'uniformità della penetrazione e della dissoluzione del solvente. Gli adesivi solubili sono per lo più materiali termoplastici o a base di poliimmide modificata, solitamente applicati mediante rivestimento a rotazione.
Debonding meccanico
Il debonding meccanico separa i wafer ultrasottili dai substrati di supporto temporanei esclusivamente applicando una forza di peeling meccanica controllata, senza calore, solventi chimici o laser. Il processo è simile alla rimozione del nastro adesivo, in cui il wafer viene “sollevato” delicatamente attraverso un'operazione meccanica di precisione.
Semicorex offre alta qualitàMandrini di distacco in ceramica porosa SIC. Se hai domande o hai bisogno di ulteriori dettagli, non esitare a contattarci.
Telefono di contatto n. +86-13567891907
E-mail: sales@semicorex.com




